Шанс для русского литографа (Asphalt)
"Кажется, что единственный для нас путь — повторение того, что сделала компания ASML. Позволю себе с этим не согласиться. На основании длительного взаимодействия с ASML и Zeiss по разработке EUV-литографа, а также собственного опыта создания экспериментального образца литографа автор убежден, что попытка копирования литографа компании ASML не приведет к успеху"
Николай Чхало
Эта статья заведующего отделом Института физики микроструктур (ИФМ) РАН, доктора физико-математических наук Николая Чхало рассказывает о новых подходах ИФМ к созданию EUV-фотолитографа (экстремальный ультрафиолет, ЭУФ) — важнейшей установки, необходимой для изготовления микропроцессоров, которые позволяют существенно облегчить их разработку и изготовление. Статья является кратким изложением препринта.
(Примечание Asphalt'а: В свою очередь, для лучшего восприятия излагаемой темы читателями АШ, краткое изложение также подверглось небольшому сокращению.)
Пределы прогресса
Прогресс микроэлектроники напрямую связан с уменьшением геометрических размеров топологических элементов. Топология и размеры элементов задаются литографией. Затраты на литографическое оборудование и стоимость самого процесса литографии могут на порядки превосходить другие затраты при производстве микросхем. Например, цена литографа с иммерсией на длине волны 193 нм может достигать 50 млн евро, литографа на длине волны 13,5 нм — от 300 млн евро, а комплект масок может стоить до 10 млн долларов и более.
Самые современные чипы в основном производятся с использованием литографии на длине волны 193 нм. Это стало возможным благодаря непрерывному развитию методов повышения разрешающей способности (Resolution Enhancement Technique, RET).
В настоящее время применение RET позволило достичь предела разрешающей способности ультрафиолетовой литографии 8 нм. Однако из-за высокой доли брака, кратного падения производительности и увеличения стоимости процесса в массовом производстве DUV литография (Deep Ultra Violet) не используется при изготовлении критических слоев чипов с минимальными топологическими размерами от 16 нм и меньше.
Разрешающую способность литографии можно повысить, перейдя к более короткой длине волны. Исследования в области EUV-литографии на длине волны 13,5 нм были начаты еще в 80-е годы прошлого столетия. И если вначале разработкой собственного рентгеновского литографа занимались в США, Японии, Нидерландах и в России, то к настоящему времени осталась только нидерландская компания ASML. Только она смогла интегрировать самые передовые достижения со всего мира в своем продукте. Другие компании и организации, достигшие успехов в разработке определенных узлов и технологий для EUV-литографа, сконцентрировались на этих разработках в интересах ASML.
Концепция ASML
Еще в 2012 году на опытных литографах (b-tools) было показано, что, если не учитывать короткий жизненный цикл элементов литографа и затраты на ремонт и простои оборудования, начиная с топологических норм 32 нм стоимость литографического процесса на EUV-машине становится меньше, чем на DUV. При уменьшении топологических размеров этот эффект только усиливается.
Но на этом пути перед разработчиками рентгеновского литографа встал ряд трудноразрешимых проблем с крайне дорогостоящими решениями. Дело в том, что производительность литографа определяется эффективностью отражающей многослойной оптики и конверсии подведенной к источнику энергии в EUV-излучение на рабочей длине волны, в спектральной полосе, равной полосе пропускания оптической системы литографа.
Если рассчитать эффективность 12-зеркальной оптической системы литографа, состоящей из коллектора, четырех зеркал осветителя, маски и шести зеркал проекционного объектива, а также учесть коэффициенты пропускания фильтра, защищающего маску от загрязнений (pellicle), и фильтра, разделяющего объемы проекционного объектива и стола с экспонируемой пластиной GDL (Gas Dynamic Lock), то эффективность системы составит менее 0,9%. На практике эта величина еще меньше из-за низкого, на уровне 41%, коэффициента отражения коллектора, наличия на поверхности Mo/Si-зеркал защитных слоев и поляризационных эффектов. Поэтому для достижения высокой производительности основные усилия разработчиков направлены на увеличение мощности лазерно-плазменного источника (ЛПИ) излучения на 13,5 нм.
Этот источник, обладающий наивысшим коэффициентом конверсии в области 13,5 нм, является основной проблемой EUV-литографа от ASML. Во-первых, это огромные габариты установки, лазерная система занимает целый этаж. Во-вторых, из-за использования уникального по параметрам газоразрядного CO2-лазера установка превысила по мощности мегаваттный уровень. В-третьих, серьезнейшие проблемы влечет за собой использование олова в литографическом процессе, которое необходимо вывести из установки, так как даже нанометровые загрязнения зеркал парами олова приведут к потере отражательной способности. Решением по защите оптики от загрязнения парами олова стало использование водорода. Использование в литографе водорода, да еще активированного ионизацией из-за облучения EUV- и DUV-излучением, предъявляет жесткие требования к материалам конструкции, сильно ограничивая их номенклатуру или сокращая срок службы.
В совокупности из-за описанных проблем из 6% конверсионной эффективности источника до промежуточного фокуса доходит менее 1,2% мощности лазерного излучения. Эти потери — результат мероприятий, защищающих оптику и другие элементы литографа от паров и высокоэнергичных ионов олова, а также от радиационных нагрузок вследствие рассеяния лазерного излучения.
Очень короткое время жизни коллектора и маски, стоимость каждого в районе миллиона евро, огромное потребление электрической энергии делают крайне высокой стоимость пользования этим видом оборудования.
По разным данным, цена выпускаемых в настоящее время литографов серии NXE:3400C и NXE:3600D превышает 300 млн евро, а нового поколения EXE:5000 — кратно больше.
Исходя из объемов рынка можно сделать вывод, что с экономической точки зрения повторять проект ASML для России бессмысленно.
Наш ответ ASML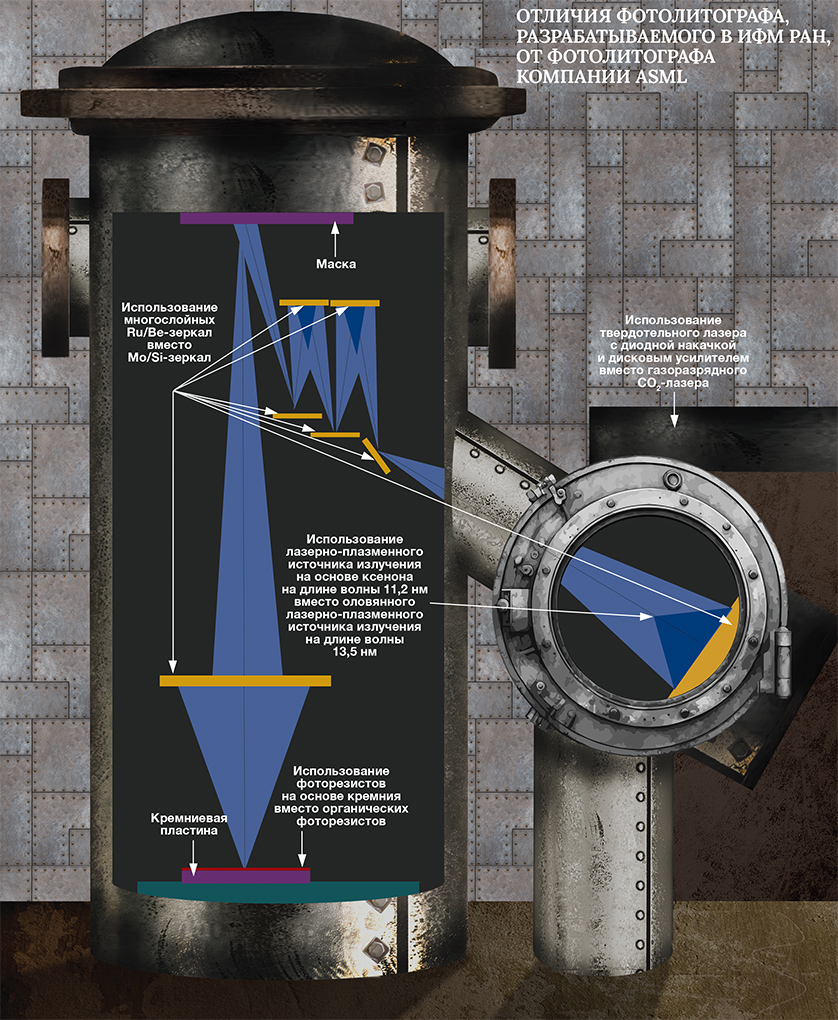
Последние достижения ИФМ РАН в области многослойной рентгеновской оптики и лазерно-плазменного источника на основе ксенона на длину волны 11,2 нм позволили по-новому взглянуть на развитие рентгеновской литографии с точки зрения снижения стоимости и дальнейшей эксплуатации литографа с сохранением минимальных технологических норм на уровне ASML ценой некоторого уменьшения его производительности. Достижение такой цели предполагает кратное снижение энергетики лазерно-плазменного источника. Если литограф от ASML — это установка мегаваттного уровня, то концепт от ИФМ РАН — порядка 0,1–0,2 МВт. Будут кардинально уменьшены габаритные размеры, повышен жизненный цикл лазера, коллектора и других элементов литографа. Появится возможность повышения эффективности рентгенооптической схемы и упрощения проекционной схемы.
В основе предложенной концепции лежат следующие инновации.
1. Уменьшение рабочей длины волны с 13,5 до 11,2 нм, что приведет к увеличению разрешающей способности объектива установки на 20%. Это позволит для достижения одинакового разрешения уменьшить его числовую апертуру*. Следствием этого будет уменьшение габаритных размеров и существенное упрощение изготовления зеркал. Поэтому можно ожидать уменьшения габаритных размеров и заметного удешевления производства объектива. А поскольку на данной длине волны применяются многослойные Ru/Be-зеркала вместо Mo/Si, то, как показывают наши исследования, существенно повысится эффективность оптической системы.
2. Замена оловянного лазерно-плазменного источника на ксеноновый на порядки уменьшает загрязнения оптических элементов продуктами разлета материала источника. Ведь ксенон — это инертный газ, и он не может загрязнять оптику. В результате кратно возрастет время жизни дорогостоящих коллектора и масок. Все это снижает затраты как на изготовление вакуумных элементов и систем, а также литографа в целом, так и на стоимость эксплуатации.
Кроме того, вместо крупногабаритного газоразрядного СО2-лазера в предлагаемом ЛПИ используется надежный малогабаритный и энергосберегающий твердотельный лазер с диодной накачкой и дисковым усилителем. Важно отметить, что в России в настоящее время нет даже экспериментального прототипа импульсного CО2-лазера с близкими к ASML параметрами, в то время как имеются передовые разработки в области мощных твердотельных гибридных лазеров.
3. Переход к длине волны 11,2 нм открывает возможность использования фоторезистов на основе кремния. Можно ожидать, что увеличение доли кремния в резисте приведет к заметному увеличению эффективности резиста на длине волны 11,2 нм по сравнению с 13,5 нм.
В приводимой ниже таблице сравниваются основные параметры литографа TWINSCAN NXE:3600D с ожидаемыми параметрами литографа, разработанного в ИФМ РАН. Ряд «внутренних» параметров литографа от ASML был восстановлен автором из анализа различных источников, но основные взяты с сайта ASML. При расчете производительности литографического процесса от ИФМ РАН были сделаны консервативные оценки.
Как видно из таблицы, достаточно консервативные оценки показывают, что при средней мощности лазера 2,7 кВт ожидаемая производительность на длине волны 11,2 нм будет меньше примерно в 2,9 раза, чем у литографа ASML. Но для фабрик, у которых рынок продукции меньше, чем у топ-5 компаний, этой величины вполне достаточно, если учесть, что из всех слоев на чипе рентгеновская литография используется только при формировании нескольких критических слоев.
Успешная реализация данной концепции, основанной на технологиях 2020-х, а не 2000-х годов, позволит достичь целей повышения доступности рентгеновской литографии для пользователей без ущерба разрешающей способности.
Почему мы уверены в успехе?
Для успешной реализации проекта в ИФМ РАН создан научно-технологический задел мирового уровня. Для изготовления рентгеновской оптики, в том числе асферической, разработана технология двустадийного формообразования. На первом этапе методом классической глубокой шлифовки-полировки с использованием уникальных полирующих составов изготавливаются плоские или сферические заготовки.
На следующем этапе методом ионно-пучкового травления осуществляются финишная полировка, асферизация и коррекция локальных ошибок.
В частности, в ИФМ РАН разработана технология напыления Ru/Be-зеркал с коэффициентами отражения на длине волны 11,4 нм до 72,2%, что заметно выше рекордных 70,15% Mo/Si-зеркал, используемых в установке ASML.
Исследования по ксеноновому источнику рентгеновского излучения были начаты почти десять лет назад. Их результаты позволяют утверждать, что КПД ксенонового источника будет не ниже, чем у оловянного.
Для литографических целей нужен импульсно-периодический лазер с энергией в импульсе десятки-сотни миллиджоулей, длительностью несколько наносекунд и средней мощностью от киловатта. В ИПФ РАН разработан экспериментальный образец такого лазера.
В области резистов для 13,5 нм ИФМ РАН и Институтом химии ННГУ им. Н. И. Лобачевского совместно были также получены значимые результаты. При переходе на резисты на основе кремния можно ожидать увеличения чувствительности путем их большего поглощения на длине волны 11,2 нм по сравнению с 13,5 нм.
В ИФМ РАН имеются значимые заделы и в области масок для EUV-литографии и свободновисящих многослойных пленок для защиты масок (pellicle) и оптики от загрязнений продуктами разложения резистов (GDL), фильтров спектральной очистки (SPF). В частности, экспериментальные литографы компании ASML оснащались этой свободновисящей оптикой. Получено около 20 совместных патентов с ASML. В настоящее время эта оптика востребована, в частности, в странах Юго-Восточной Азии. Ну и, наконец, в ИФМ РАН имеются компетенции в области сканирующих систем и автофокуса, что ранее позволило создать первый в России макет литографа на длину волны 13,5 нм.
Дорожная карта выполнения проекта